
小型化と高性能化を実現する、様々な工法のフリップチップボンディングに対応しております。
様々な先端技術を保有しているため、開発・応用等ご要望や試料によって最適なご提案が可能です。
ワイヤボンディングのみや特殊実装もお受けしており、実装は1個から承っております。
お気軽にご相談ください。
フリップチップ実装
| SBB Stud Bump Bonding |
GGI Gold to Gold Interconnection |
ESC/ESC5 Epoxy encapsulated Solder Connection |
||
| 接合方法 | 導電性接着剤 | 固相拡散 | Au-Sn(ハンダ)固相拡散 | |
| 接合構造 |
 |
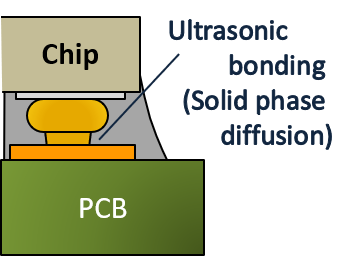
|
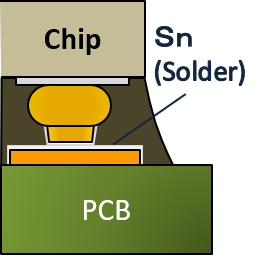 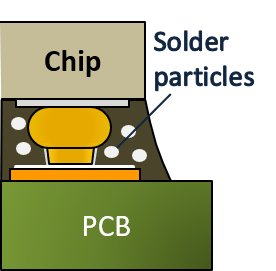 |
|
| 接合状態 |  |
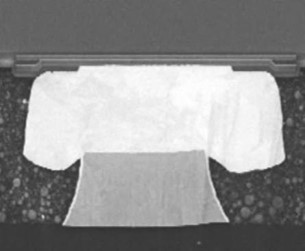 |
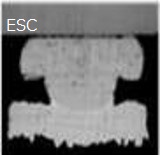 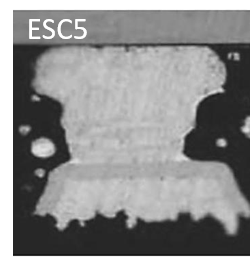 |
|
| GBS Gold Bump Soldering |
C4 Controlled Collapse Chip Connection |
CPB Copper Pillar Bonding |
ACF/ACP Anisotropic Conductive Film/Paste |
NCF/NCP Non Conductive Film/Paste |
|
| 接合方法 | 合金接合 | 合金接合 | 合金接合 | 導電粒子圧接 | Auバンプ圧接 |
| 接合構造 | 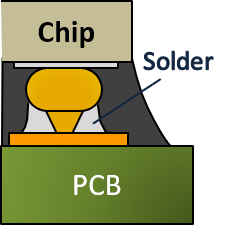 |
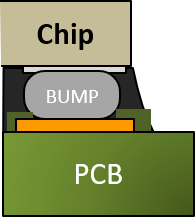 |
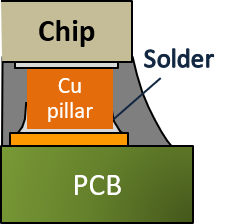 |
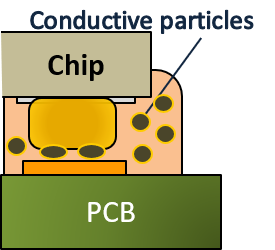 |
 |
| 接合状態 | 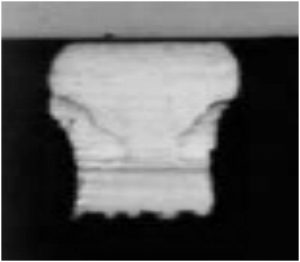 |
 |
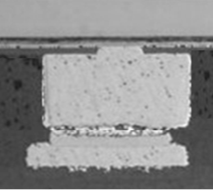 |
 |
 |
基板間接合
| FOB Film on Board |
FOF Film on Film |
BOB Board on Board |
|
| 接合方法 | 熱圧着、ハンダ、超音波 | 熱圧着、ハンダ、超音波 | 各種板間接続コネクタ |
| 接合構造 |  |
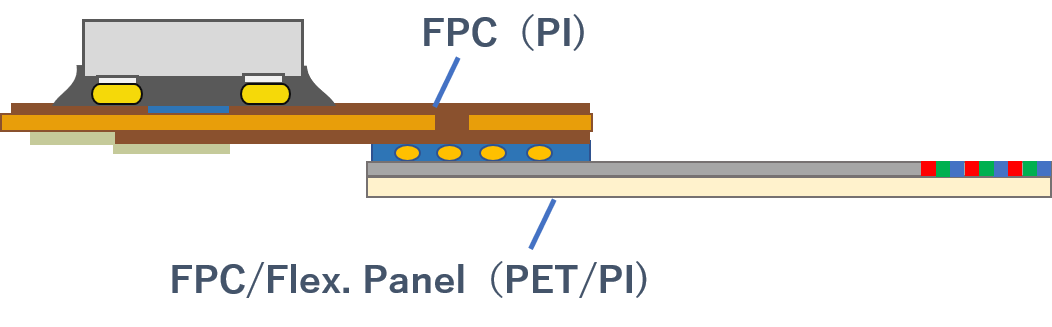 |
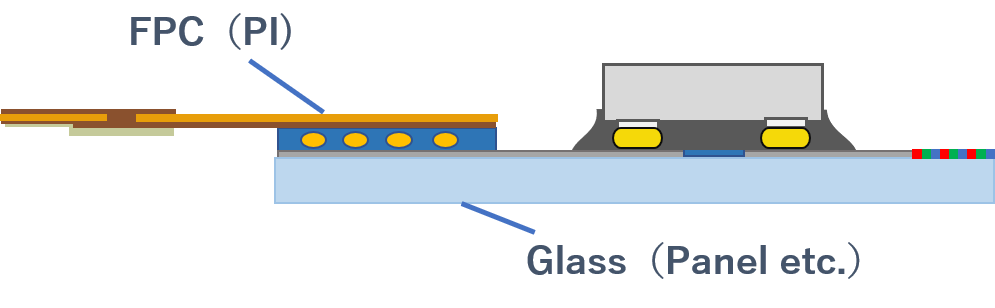 |
Auスタッドバンプ/ワイヤボンディング
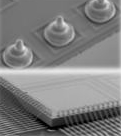 |
項 目 | 仕 様 | ||
| バンプ加工 | Auスタッドバンプ | 個片チップ(社内) | Chip_size :30mm×30mm以下 | |
| ウェハー(協力工場) | Wafer_size :6~8 inch | |||
| ハンダバンプ | ウェハー(協力工場) | Wafer_size :5~8 inch | ||
| ワイヤボンディング | Auワイヤ | ボンディングエリア 50mm×40mm以内 | ||
| Auワイヤ径 | φ20μm~φ38μm (更に細径ワイヤの加工検証中) | |||
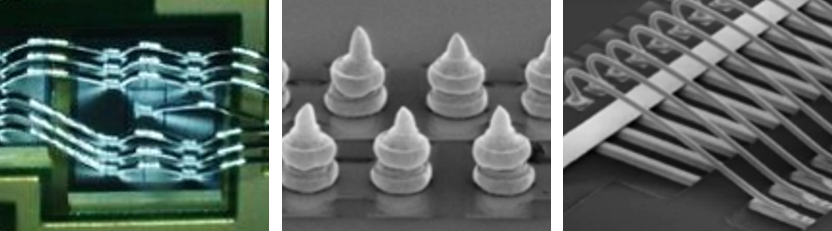
・スタッドバンプボンディング(Φ25m/40um Pitch)
・多段積バンプ形成(2段~3段バンプ(Φ40um/50um Pitch)
・ワイヤボンディング(40um Pitch)
・ウェッジボンディング(Al,Au)
・ハンダバンプ
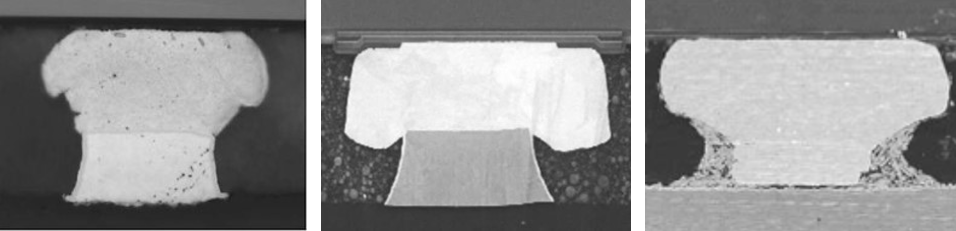
・超音波接合(GGI:Gold to Gold Interconnect)
・導電性接着剤接続(SBB:Stud Bump Bonding)
・マイクロソルダリング(C4/Cu pillar)
・熱圧着ボンディング(ACF/ACP/NCP etc.)
・Auハンダ接合(GBS:Gold Bump Soldering)
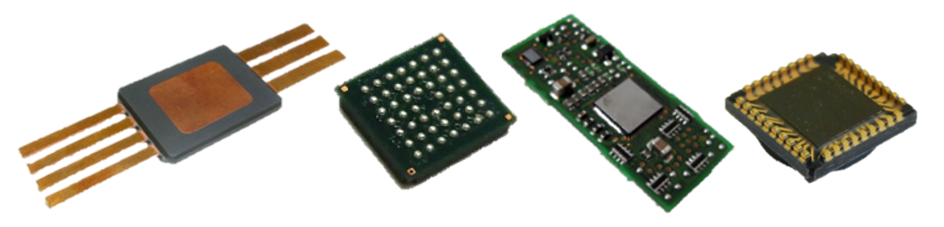
・COF(Chip on Film)モジュール
・COM(Chip on MID)モジュール
・COC(Chip on Chip)モジュール
・FOB(Film on Board)モジュール
・次世代パワーモジュール技術
・フリップチップセンサモジュール
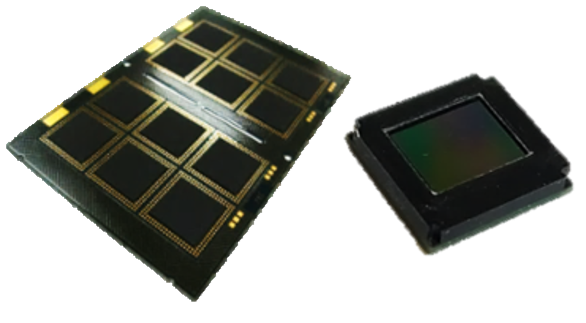
・アンダーフィル(Flip Chip)
・サイドフィル封止(Image Sensor etc.)
・ポッティング/ダム・フィル封止(Wire Bonding)
・トランスファーモールド
Copyright © マイクロモジュールテクノロジー株式会社 All rights reserved.